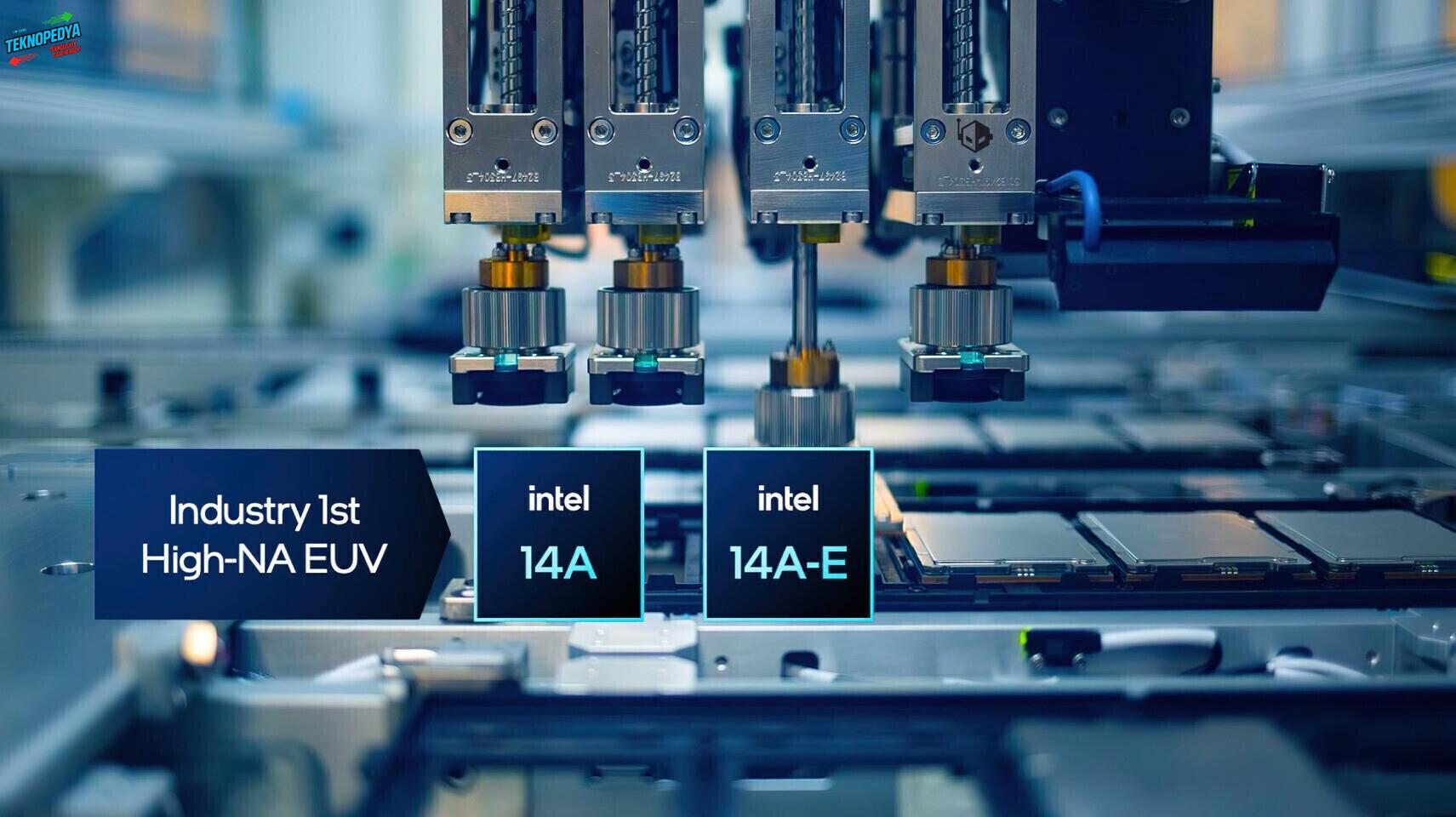 Yarı iletken üretiminde yeniden iddialı bir konuma gelmeye çalışan Intel’in çip üretim birimi Foundry, sektörün en büyük oyuncularıyla olası iş birlikleriyle dikkat çekiyor. UBS Group tarafından paylaşılan son değerlendirmelere göre şirket, önümüzdeki sonbahar döneminde birden fazla büyük ölçekli üretim anlaşması duyurmaya hazırlanıyor. Bu sürecin en önemli tetikleyicisi ise Intel’in yeni nesil üretim süreci için hazırladığı 14A süreci.
Yarı iletken üretiminde yeniden iddialı bir konuma gelmeye çalışan Intel’in çip üretim birimi Foundry, sektörün en büyük oyuncularıyla olası iş birlikleriyle dikkat çekiyor. UBS Group tarafından paylaşılan son değerlendirmelere göre şirket, önümüzdeki sonbahar döneminde birden fazla büyük ölçekli üretim anlaşması duyurmaya hazırlanıyor. Bu sürecin en önemli tetikleyicisi ise Intel’in yeni nesil üretim süreci için hazırladığı 14A süreci. Apple, AMD, Nvidia ve Google öne çıkıyor
Haberi okuduğunuz için teşekkürler, bizi takip etmeyi unutmayın!
Sektör kulislerinde dolaşan bilgilere göre Apple, AMD, Nvidia, Google ve Broadcom gibi dev şirketler Intel’in üretim teknolojilerini kullanma ihtimalini ciddi şekilde değerlendiriyor. Bu kapsamda özellikle 18A, 18A-P, 18A-PT ve henüz geliştirme aşamasındaki 14A süreci öne çıkan seçenekler arasında yer alıyor.
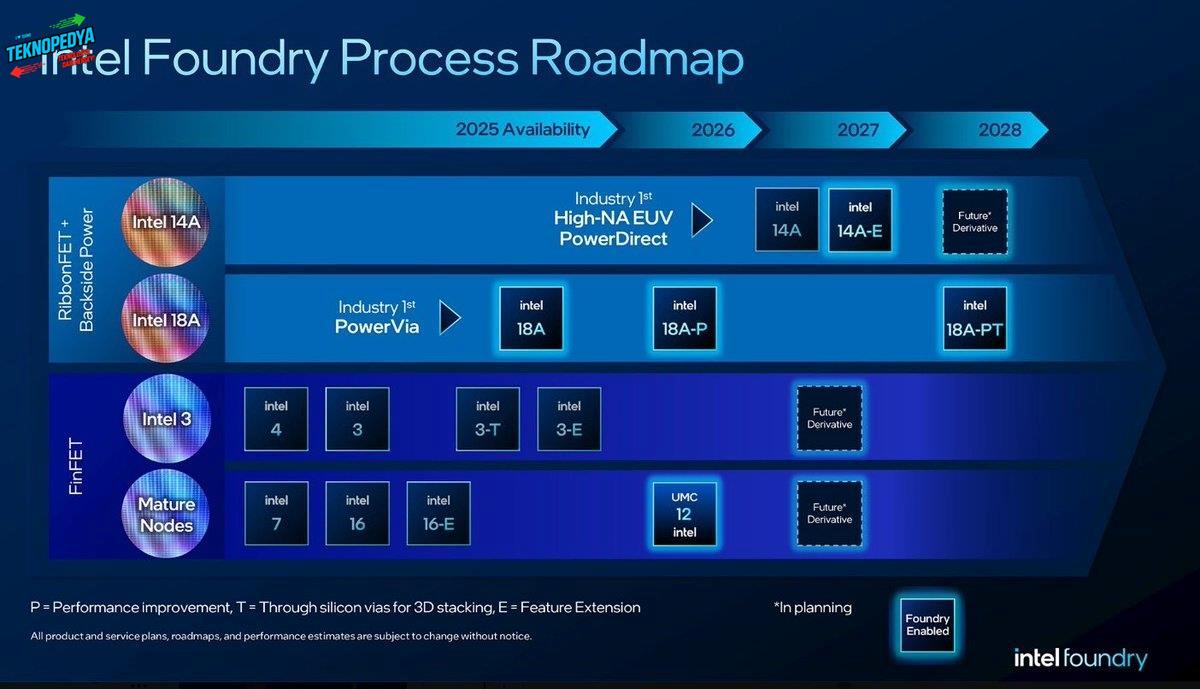 Apple tarafında dikkat çeken iddialar, şirketin kendi geliştirdiği M serisi işlemcilerin bir kısmını 2027 itibarıyla 18A-P üretim süreciyle Intel’e ürettirebileceği yönünde. Google’ın ise farklı bir strateji izleyerek kendi yapay zeka hızlandırıcıları olan TPU’larda Intel’in EMIB ve Foveros 3D paketleme teknolojilerini kullanabileceği konuşuluyor.
Apple tarafında dikkat çeken iddialar, şirketin kendi geliştirdiği M serisi işlemcilerin bir kısmını 2027 itibarıyla 18A-P üretim süreciyle Intel’e ürettirebileceği yönünde. Google’ın ise farklı bir strateji izleyerek kendi yapay zeka hızlandırıcıları olan TPU’larda Intel’in EMIB ve Foveros 3D paketleme teknolojilerini kullanabileceği konuşuluyor. Intel agresif ilerliyor
Bugüne kadar birçok büyük teknoloji şirketi, üretim tarafında güvenilirlik, yüksek kapasite ve gelişmiş paketleme çözümleri nedeniyle ağırlıklı olarak TSMC’yi tercih etti. TSMC’nin özellikle yüksek performans ve düşük güç tüketimi dengesini büyük ölçekli üretimde başarıyla sunabilmesi bu tercihte belirleyici oldu.
 Ancak Intel, son dönemde çip üretim hizmetlerini büyütmek adına ciddi yatırımlar yapıyor. UBS analizine göre bu yatırımların karşılığı olarak 2026 sonbaharında birden fazla büyük müşterinin Intel ile resmi işbirlikleri yapması bekleniyor.
Ancak Intel, son dönemde çip üretim hizmetlerini büyütmek adına ciddi yatırımlar yapıyor. UBS analizine göre bu yatırımların karşılığı olarak 2026 sonbaharında birden fazla büyük müşterinin Intel ile resmi işbirlikleri yapması bekleniyor. Intel Foundry’nin rekabet avantajı yalnızca üretim süreçleriyle sınırlı değil. Şirketin EMIB, EMIB-T ve EMIB-M gibi gelişmiş paketleme teknolojileri, çoklu yonga (chiplet) tasarımlarını daha verimli hale getiriyor. Bu teknolojiler sayesinde 2D, 2.5D ve 3D mimarilerle birden fazla yonga ve yüksek bant genişliğine sahip HBM bellek modülleri tek bir pakette birleştirilebiliyor.
Intel, tek bir pakette 47 yonganın kullanıldığını bile gösterdi ve gelecekte paket başına multi-kilovat seviyesinde güç tüketen çözümlerin mümkün olabileceği ifade ediliyor. Rakip cephede ise TSMC’nin CoWoS paketleme teknolojisinde bazı üretim ve kapasite zorluklarının yaşandığı belirtiliyor.







